【复材资讯】北京大学/深圳理工合作,二维材料登上Nature Materials!
研究背景
高质量电介质与通道材料的集成一直是硅电子器件发展过程中的核心任务,六方氮化硼 (hBN) 已成为下一代大规模集成电子器件中电介质集成的有前途的保护层。
关键问题及新思路
然而,hBN的发展主要存在以下问题:
1、理想的hBN薄膜应具有大面积、超平、单晶的特征
六方氮化硼 (hBN) 具有原子级平整度和无悬挂键,被广泛用作高κ电介质集成的优异界面层和保护层,这要求hBN 薄膜应面积大、超平、单晶并与先进的微电子制造兼容。
2、目前仍未实现晶片级均匀性的超平整hBN
近来,人们不断尝试利用化学气相沉积(CVD)技术在金属基底上生长高质量的单晶hBN薄膜,例如采用阶梯引导外延机制在邻位Cu(110)箔、Ni(111)箔和Cu(111)晶片上生长,或采用自准直机制在液态金上生长。然而,具有晶片级均匀性的超平整hBN尚未实现。
有鉴于此,北京大学彭海琳教授、深圳理工大学丁峰讲席教授等在Nature Materials发表了题为Ultraflat single-crystal hexagonal boron nitride for wafer-scale integration of a 2D-compatible high-κ metal gate的论文,报告了在 Cu0.8Ni0.2(111)/蓝宝石晶片上外延生长4英寸超平单晶hBN。hBN和Cu0.8Ni0.2(111) 之间的强耦合抑制了皱纹的形成并确保了平行排列的hBN域的无缝缝合,从而产生了晶圆级超平单晶 hBN薄膜。使用超平hBN作为保护层,作者将晶圆级超薄高κ电介质集成到具有无损伤界面的二维 (2D) 材料上。所获得的hBN/HfO2复合电介质表现出超低电流泄漏(2.36 × 10−6 A cm−2)和0.52 nm的超薄等效氧化物厚度,符合国际设备和系统路线图的目标。本工作的发现为超平二维材料的合成和未来二维电子产品的集成铺平了道路。

技术方案:
1、设计了超平整hBN单晶
作者通过调控Ni浓度,实现hBN与CuNi(111) 强耦合,促进单取向生长,制备了超平整hBN薄膜。
2、表征了超平整六方氮化硼薄膜的结果
作者通过多种表征证实Cu0.8Ni0.2(111)晶片上生长的hBN薄膜具有超平整表面,无皱纹,粗糙度低至0.5 nm,保持单晶性,转移后平整度不减。
3、解析了Cu0.8Ni0.2(111)基材上褶皱抑制机制
作者通过DFT和MD模拟揭示,Cu0.8Ni0.2(111)表面与hBN的强耦合显著增强粘附能和摩擦力,有效防止褶皱形成,促进超平hBN生长。
4、展示了HKMG在二维材料上的集成
作者证实了超平hBN薄膜作为2D电子器件的缓冲层,可实现均匀HfO2层生长,EOT值0.52nm,漏电流极低,电子迁移率高,具有通用性。
技术优势:
1、实现了超平整单晶hBN单层的合成
作者在4英寸Cu0.8Ni0.2(111)/蓝宝石晶片上成功合成了超平整单晶hBN单层。这种合成方法利用 hBN和Cu0.8Ni0.2(111)之间的强耦合,有效消除了冷却过程中的皱纹和台阶聚束,从而实现了hBN域的平行排列和无缝拼接。
2、开创了hBN与金属基底强耦合的创新应用
通过hBN与金属基底之间的强耦合,不仅可以抑制皱纹和台阶聚束的形成,还能增加粘附能和摩擦力,进而抑制吸附原子的迁移,这对于二维材料的合成具有重要意义,其成功应用为二维材料的合成和应用提供了新的策略和思路。
图文解读
超平整hBN单晶设计
通过精确控制 CuNi(111) 中Ni原子浓度,作者成功实现了与hBN之间的强耦合,通过工业兼容的溅射和退火工艺制备单晶CuNi(111)/蓝宝石晶片。获得的CuNi(111)晶片的表面粗糙度降低至约0.34 nm,几乎没有观察到台阶聚束。当Ni浓度增加至20%时,hBN畴区的取向一致性得到保证,无缝拼接成连续薄膜,且薄膜与基底间的距离缩短至2.7 Å,显示出比范德华相互作用更强的耦合特征。此外,还开发了一种循环退火的后处理方法,以消除 hBN中的纳米起伏,进一步提升其防氧化性能。这些成果不仅为高质量二维材料的合成提供了新的策略,也为未来电子器件的发展奠定了基础。
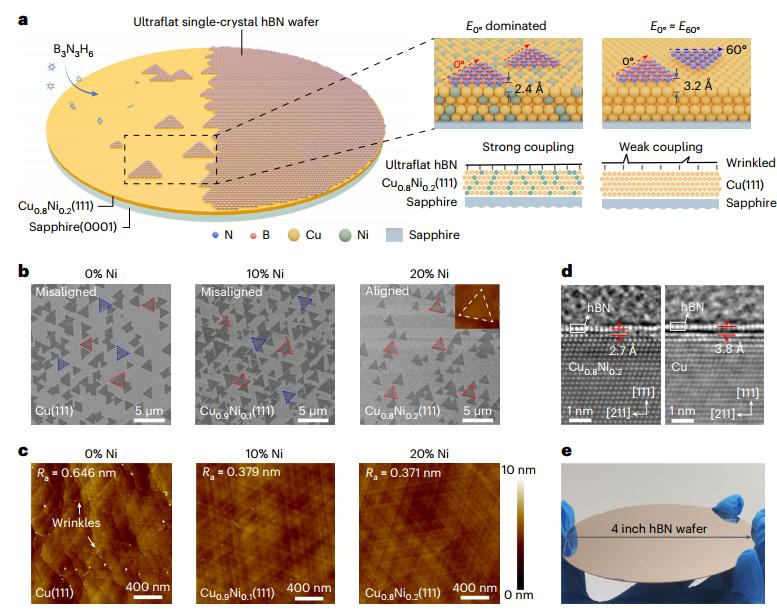
图 Cu0.8Ni0.2(111)晶片上的超平整hBN单晶设计
超平整六方氮化硼薄膜的表征
在Cu0.8Ni0.2(111) 晶片上成功生长的hBN薄膜,实现了大面积超平整表面,表面高度均匀,未观察到皱纹或粘附层。通过AFM表征确认了无皱纹和台阶束,表面高度变化仅为0.5-1nm,平均粗糙度 (Ra)约为0.5 nm,与工业硅片相当。相比之下,在铜箔上生长的hBN表面粗糙,存在密集皱纹和台阶束。此外,超平整 hBN薄膜在转移到云母基底后,保持了超平整性,表面粗糙度与原始云母表面相似,为Ra≈0.2 nm。通过低能电子衍射 (LEED) 和选区电子衍射 (SAED) 表征,确认了hBN薄膜的单晶性。STEM图像揭示了hBN单层的完美晶格,B原子和N原子清晰分辨,XPS和拉曼光谱展示了B-N化学键合结构。

图 超平整六方氮化硼薄膜的表征
褶皱抑制机制
通过密度泛函理论 (DFT) 计算和分子动力学 (MD) 模拟,作者深入探究了hBN与Cu0.8Ni0.2(111) 表面之间的强耦合效应。研究表明,hBN与该合金表面之间的粘附能和摩擦力显著增加,从而有效抑制皱纹的形成。具体来说,hBN 与 Cu0.8Ni0.2(111) 之间的粘附能每对BN大约增加了~90 meV,摩擦力增加了四倍,这种强耦合源于 Ni 3d 带与BN π 态之间的强杂化。此外,通过MD 模拟,定量解释了Cu(111)表面皱纹的形成和 Cu0.8Ni0.2(111) 表面皱纹的抑制现象,指出 hBN 薄膜的压应变达到临界值时会突然形成皱纹,而强耦合条件下的临界应变大于在Cu(111)上的临界应变。这些发现为实现超平hBN生长提供了理论依据。

图 Cu0.8Ni0.2(111)基材上褶皱抑制机制
HKMG在二维材料上的集成
超平hBN薄膜因其超平滑特性和单晶性质,成为2D半导体和栅极电介质之间理想的缓冲层。通过原子层沉积 (ALD) 技术,作者在hBN薄膜上成功生长了均匀超薄的HfO2层,构建了超薄高κ/金属栅极 (HKMG)。hBN上的HfO2层平整致密,无针孔,厚度可控,范围为2 nm 至10 nm。HKMG的横截面STEM图像显示2 nm HfO2/hBN 层是连续且均匀的。超薄 HfO2的均匀无针孔形貌进一步保证了介电性能,hBN/HfO2的EOT值约为1 nm,当HfO2层厚度约为1.40 nm时,EOT值达到最小0.52 nm 。此外,hBN/HfO2复合电介质与石墨烯集成表现出优异的电子性能,室温下的迁移率约为 10,000 cm⊃2;V⁻⊃1;s⁻⊃1;,载流子密度低于5 × 10⊃1;⊃1; cm⁻⊃2; 。这种可转移的hBN/HfO2电介质也显示出与2D半导体如Bi2O2Se的通用性。
总结与展望
总之,作者开发了一种在Cu0.8Ni0.2(111) 上外延生长4英寸超平单晶hBN晶片的方法。通过利用 hBN和Cu0.8Ni0.2(111)之间的强相互作用,有效地消除了hBN薄膜中的晶粒边界和皱纹,从而扩展了高质量均匀二维材料的生长方法,这对电子工业至关重要。通过与工业兼容的 ALD 工艺,成功在 4 英寸超平hBN晶片上沉积了均匀的超薄HfO2层。hBN/HfO2表现出良好的介电性能,EOT小0.52 nm)且漏电流低(2.36×10-6 A cm-2)。通过转移工艺将石墨烯封装在制备好的hBN/HfO2中,确保了石墨烯与电介质之间的无损伤界面,展现了石墨烯的固有特性,在室温下具有~10,000 cm2 V−1 s−1 的高迁移率,并且石墨烯晶体管具有良好的栅极控制,滞后低至40 mV。该工作不仅揭示了高质量2D 材料的生长机制,还展示了一种将HKMG与2D材料集成的有效策略,为未来的2D晶体管铺平了道路。
来源:纳米人
论文链接:
Wang, Y., Zhao, C., Gao, X. et al. Ultraflat single-crystal hexagonal boron nitride for wafer-scale integration of a 2D-compatible high-κ metal gate. Nat. Mater. (2024).
https://doi.org/10.1038/s41563-024-01968-z
免责声明:中国复合材料学会微信公众号发布的文章,仅用于复合材料专业知识和市场资讯的交流与分享,不用于任何商业目的。任何个人或组织若对文章版权或其内容的真实性、准确性存有疑议,请第一时间联系我们。我们将及时进行处理。
继续滑动看下一个轻触阅读原文

中国复合材料学会向上滑动看下一个
原标题:《【复材资讯】北京大学/深圳理工合作,二维材料登上Nature Materials!》

